靶材 Bonding 到背板上的方式主要有 Solder Bonding 和 Diffusion Bonding 二種.
Solder Bonding 用 <250°C 的低溫銲料 (Solder) 把靶材和背板接合起來, 最常用的銲料是純 In 和 Sn 合金. 靶材使用時必須確保 Bonding 介面的溫度在 100°C以下, 因銲料溫度不需到熔點, 只要軟化就會造成靶材的位移或掉靶 (Debond), 進而造成設備停機.
Solder Bonding 的缺陷來自介面處有空孔, 有二個原因會造成空孔, 一是 Bonding 操作手法不當, 另一是銲料與靶材或背板不潤濕 (Wetting). 因許多材料與 In 不親和, 可以在靶材上 Coating 一層與In潤濕的介面物質, 來改善潤濕性.

靶材 Debond
Diffusion Bonding 不使用任何銲料, 將靶材與銅背板在高溫下施以高壓, 經由二者原子的相互擴散形成金屬鍵結. 此法形成的銲接介面強度高於靶材與背板, 因此沒有掉靶 (Debond) 的問題. 只是因無法讓靶材與背板脫離, 背板無法回收使用, 每次都要換新的.

ZrY+Cu

Ag+Cu
Bonding 的品質指標是 ”接合率 (Bonding Ratio)”, 檢測是利用 C-Scan 超音波掃描, 經由圖像化的介面掃描影像, 可清楚判讀缺陷位在何處?
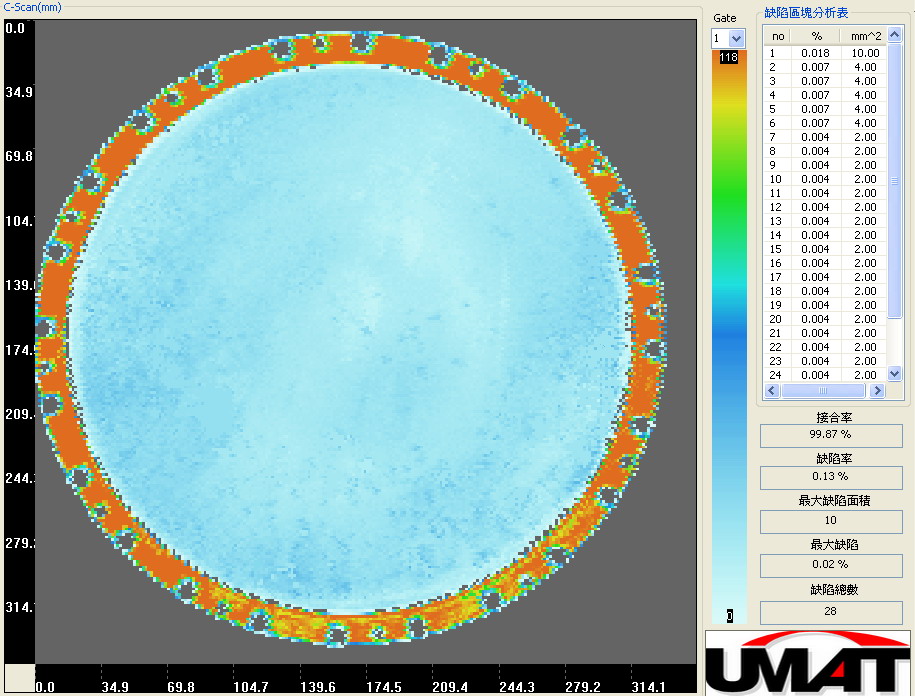
Bonding 良好
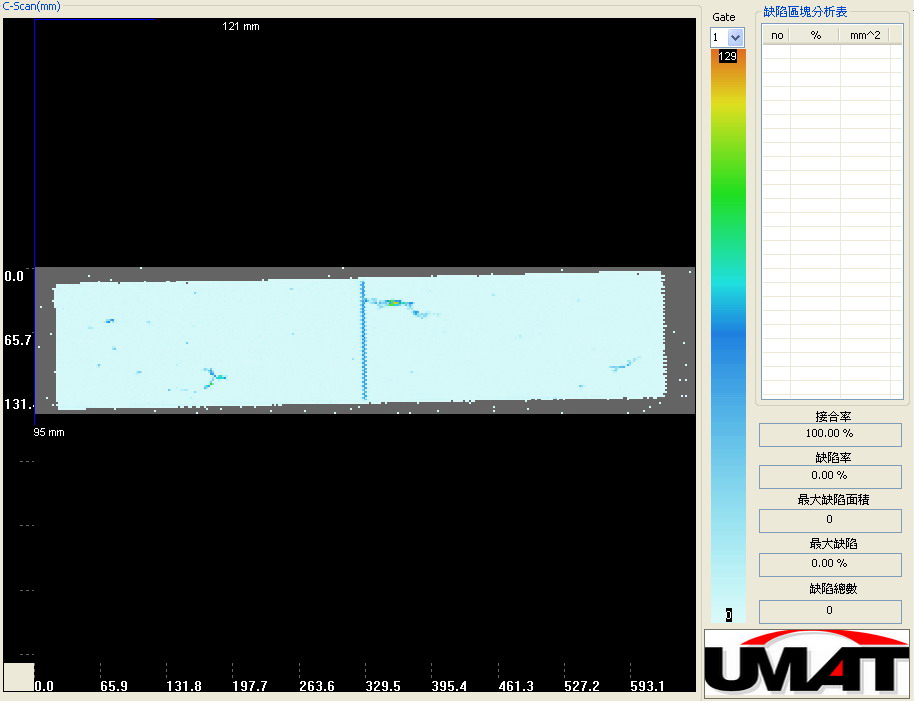
Bonding 缺陷


